WLP Fan-In 패키징의 전체 공정을 RCF → RDL → PSV → UBM → Ball Drop 순서로 정리한 종합 기술 가이드입니다.
Fan-In WLP(Wafer Level Package)는 칩과 패키지 크기가 동일한 구조를 갖는 패키징 기술로, 모바일, 웨어러블, CIS, PMIC 등 소형화·저전력 제품군에서 널리 사용됩니다. WLP는 모든 패키징 단계가 웨이퍼 상에서 이루어지며, 공정 흐름이 비교적 간결함에도 매우 높은 정밀도가 요구됩니다.
WLP의 기본 구조를 이해하려면 먼저 개념을 검토하는 것이 좋습니다.
WLP의 기본 원리는 Fan-In 구조와 공정 특징을 정리한 아래 내용을 참고하시면, 도움이 될거라 예상됩니다.
[WLP란 무엇인가]
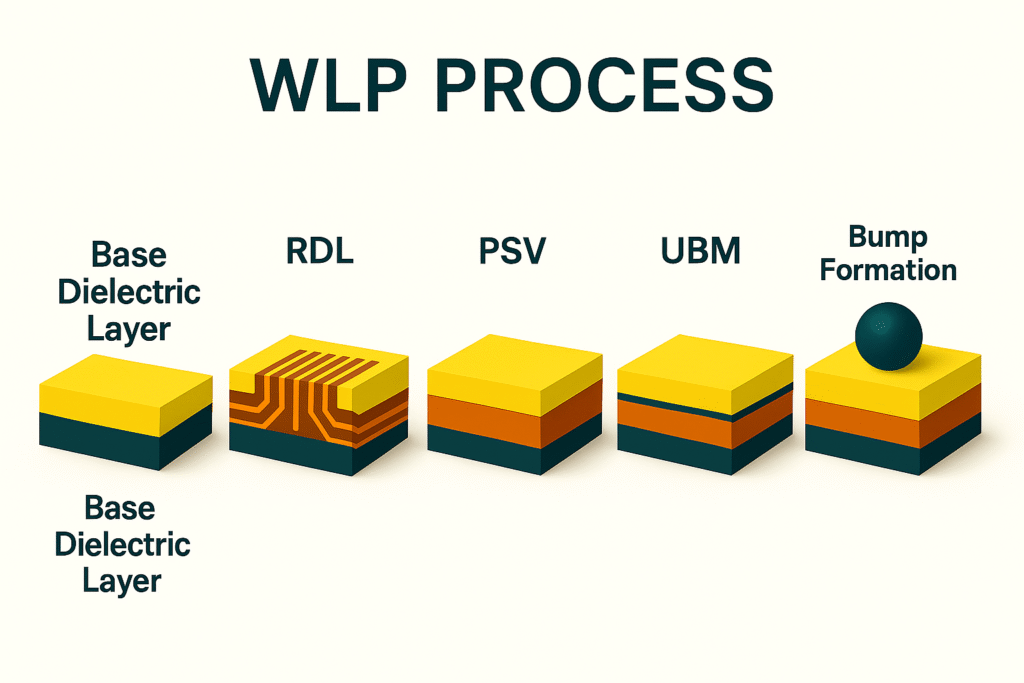
아래에서는 WLP 공정 전체의 흐름을 각 단계별로 정리하고, 세부 공정에 대한 상세 설명은 개별 시드 콘텐츠로 연결해 제공합니다.
1. WLP 전체 공정 개요
WLP는 아래와 같이 크게 다섯 단계로 구성됩니다.
- Base Dielectric Layer
- RDL(Re-Distribution Layer)
- PSV(Passivation)
- UBM(Under Bump Metallization)
- Ball Drop
각 공정은 독립적이면서도 서로 영향을 주기 때문에, 흐름 전체를 이해하는 것이 품질 관리와 공정 설계에 필수적인 중요한 공정들입니다.
2. Base Dielectric Layer공정
2.1 Base Dielectric Layer의 목적
Base Dielectric Layer는 WLP 공정의 첫 단계로, 칩 표면의 단차를 보정하고 RDL·PSV·UBM 공정이 안정적으로 진행될 기반층을 만드는 역할을 합니다.
Base Dielectric Layer는 Layer 0으로 취급되며 이후 모든 공정의 품질을 좌우합니다.
2.2 더 자세한 내용
Base Dielectric Layer 공정 구조와 흐름은 아래 글 참고하시면 도움이 될거라 예상됩니다.
[Base Dielectric Layer 공정 자세히 보기]
3. RDL(Re-Distribution Layer) 공정
3.1 배선 재배치 역할
RDL은 칩의 패드 위치를 범프 배열에 맞게 재배치하는 단계로, WLP의 전기적 성능을 결정하는 핵심 층입니다.
RDL의 금속 도금 두께, 절연층 평탄도, 패턴 정밀도는 패키지 신뢰성에 직접 영향을 줍니다.
3.2 더 자세한 내용
RDL 공정의 상세 공정과 구조 설명은 아래 링크 참고 부탁드려요
[RDL 공정 자세히 보기]
4. PSV(Passivation) 공정
4.1 절연 및 보호
PSV는 RDL을 보호하고 이후 UBM 형성을 위해 패드 영역만 오픈하는 절연 공정입니다.
패드 오픈 크기와 정렬 정밀도는 접합 품질에 큰 영향을 미칩니다.
4.2 더 자세한 내용
PSV 단계의 절연 재료, 공정 흐름은 아래 링크 참고 부탁드립니다.
[PSV 공정 자세히 보기]
5. UBM(Under Bump Metallization) 공정
5.1 금속 접합 기반 형성
UBM은 범프가 부착될 수 있도록 RDL 위에 안정적인 금속 스택을 형성하는 단계입니다.
Ni/Cu 스택이 일반적이며, 금속 확산·IMC 형성을 제어해 접합 신뢰성을 확보합니다.
5.2 더 자세한 내용
UBM 공정의 금속 스택 구성과 공정 흐름은 아래 글 참고 부탁드립니다.
[UBM 공정 자세히 보기]
6. Bump Formation 공정
6.1 범프 형성 마지막 단계
Bump Formation은 UBM 위에 솔더볼을 배치하고 리플로우하여 최종 범프 구조를 만드는 공정입니다.
WLP는 기판이 없기 때문에 Bump Formation 품질이 곧 패키지 성능입니다.
6.2 더 자세한 내용
Bump Formation의 공정 흐름과 품질 이슈는 아래 링크 참고해주세요
[Bump Formation 공정 자세히 보기]
7. WLP Fan-In 공정의 특징과 FO-WLP와의 차이
WLP는 패키지 크기가 칩 크기와 동일한 Fan-In 구조이지만, 범프 수 증가나 고밀도 배선이 요구되는 제품에서는 FO-WLP가 활용됩니다.
FO-WLP의 특징과 RCF(Reconstitution) 기반 공정 흐름은 아래 링크에서 확인할 수 있습니다.
[FO-WLP란 무엇인가]
8. 마지막 말
WLP는 Base Dielectric Layer → RDL → PSV → UBM →Bump Formation 순으로 진행되며, 각 단계는 공정별로 독립성이 있으면서 서로 강하게 연계되어 있습니다. 특정 단계에서 품질 문제가 발생하면 이후 공정 전체에 영향을 주기 때문에, 공정 초기부터 기반층(Base Dielectric Layer) 품질을 안정적으로 확보하는 것이 중요합니다. 각 공정을 개별적으로 이해하고 연결해 보면 WLP의 전체 구조가 보다 명확해지고, 공정 최적화와 이상 여부를 빠르게 판단하는 데 도움이 될 거라 예상됩니다. 처음 기본을 잘 이해해야 하니, 꼭 인지해주세요.