Ball Drop 공정은 WLP Fan-In 구조에서 UBM 위에 솔더볼을 형성해 외부 기판과 전기적으로 연결될 Fan-In WLP에서 Bump Formation은 패키지 단자를 실제로 완성하는 최종 단계입니다. 이 과정에서 솔더볼을 UBM 위에 정확하게 배치하고, 리플로우를 통해 금속 접합 구조를 형성합니다. 범프의 직경, 높이, IMC 형성 품질은 후공정 실장(SMT)과 기판 접합 신뢰성을 결정하며, Fan-In WLP는 패키지 크기와 칩 크기가 동일하므로 범프 편차와 접합 불량에 특히 민감합니다.
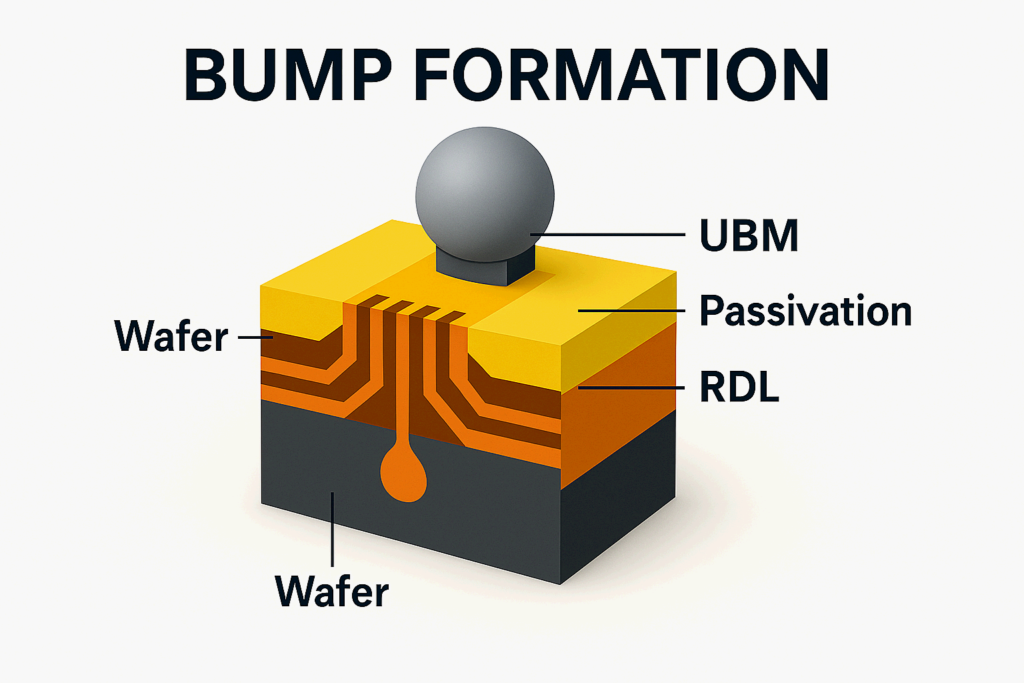
UBM 공정에서 Barrier Layer와 Wetting Layer가 안정적으로 형성되어 있어야 균일한 범프 형성이 가능하므로, UBM 단계에 대한 이해는 Bump Formation 품질 평가의 핵심 기초로, 아래 UBM 공정 설명 글 참고 부탁드립니다.
[UBM 공정 설명 보기]
1. Bump Formation 공정 개요
1.1 목적
- 솔더볼을 UBM 패턴 위에 정확히 배치
- 리플로우를 통해 UBM–솔더 간 금속 접합(IMC) 구조 형성
- 외부 기판(PWB 또는 BGA Substrate)과 연결되는 최종 단자 완성
1.2 Fan-In WLP에서의 중요성
Fan-In 구조는 패키지 면적이 칩 크기와 동일하므로 범프 균일성이 전체 수율에 직접적인 영향을 줍니다.
주요 영향 요소:
- 범프 높이 편차
- Wetting 불량
- IMC 형성 불량
- Void 발생
- Bridging(Short)
이 중 범프 높이 편차와 Wetting 불량은 SMT 접합에서 치명적 문제로 이어집니다.
2. Bump Formation 구조
2.1 솔더볼 구성
Fan-In WLP에서는 Lead-Free 솔더 합금이 주로 사용됩니다.
대표 조성:
- SAC305 (Sn96.5 / Ag3.0 / Cu0.5)
- SAC405 (Sn95.5 / Ag4.0 / Cu0.5)
솔더볼 직경은 제품 요구에 따라 80~300 µm 범위에서 설정됩니다.
2.2 UBM–솔더 접합 구조
범프는 다음과 같은 계층 구조로 이루어집니다.
- 솔더볼
- Cu Capping Layer
- Ni Barrier Layer
- Ti/TiW Adhesion Layer
- PSV 절연층
리플로우 과정에서
Sn + Ni → Ni₃Sn₄ IMC(금속간화합물) 이 형성되며,
적절한 IMC 두께는 접합 강도를 확보하는 핵심 요소입니다.
3. Bump Formation 공정 흐름
3.1 Flux 도포
Flux는 솔더 접합에서 다음 기능을 수행합니다.
- UBM 표면 산화막 제거
- 젖음성(Wetting) 향상
- 솔더볼의 본딩 안정화
- 리플로우 시 산화 방지
Flux 도포가 과도하거나 부족하면 다음 문제가 발생합니다.
- Wetting 불량
- Ball Shift
- IMC 형성 불량
Flux 종류는 Water-soluble, No-clean 등이 있으며, 공정 조건에 맞는 선택이 중요합니다.
3.2 솔더볼 배치
Fan-In WLP에서는 주로
- Flux 인쇄 후 Ball Drop 방식
- Ball Jetting 방식
이 사용되며, Pick-and-Place 방식은 미세 Pitch에서는 제한적입니다.
솔더볼은 UBM 패드와 1:1로 정렬되어야 하며, 정렬 오차는 Bridging 또는 Wetting 불량을 유발합니다.
3.3 리플로우(Reflow)
솔더볼이 녹아 UBM과 금속적으로 접합되는 단계입니다.
리플로우는 일반적으로 다음 네 구간으로 구성됩니다.
- Preheat
- Soak
- Peak (약 230~260°C 범위, Lead-free 기준)
- Cool Down
리플로우 품질은 다음에 직접적인 영향을 줍니다.
- IMC 두께 및 균일성
- Wetting 품질
- Void 발생
- 범프 높이
- 금속 박리 여부
리플로우는 범프 신뢰성을 결정하는 핵심 요소입니다.
3.4 세정(Cleaning)
Flux 잔사(Remnant)를 제거하기 위한 단계입니다.
잔사가 남으면
- 솔더 joint 부식
- 이온성 오염
- IMC 불안정
- 접합 강도 감소
문제가 발생할 수 있습니다.
Water-soluble Flux는 세정이 필수,
No-clean Flux는 조건에 따라 잔사 평가 후 세정 여부를 결정합니다.
4. Bump Formation에서 발생하기 쉬운 불량
4.1 Wetting 불량
원인:
- Flux 부족
- UBM 산화
- 솔더볼 산화막
- 리플로우 온도 또는 램프 속도 불량
결과:
- IMC 형성 불량
- 접합 저항 증가
4.2 범프 높이 편차
주요 원인:
- UBM 두께 편차
- Flux량 편차
- Ball Drop 정렬 오차
- 리플로우 볼륨 차이
Fan-In에서는 Height 균일성 확보가 매우 중요합니다.
4.3 Bridging(short)
볼 간격이 좁거나 정렬 오차가 있을 때 발생합니다.
특히 미세 Pitch 제품은 Ball Jetting 품질 관리가 중요합니다.
4.4 Void
Void는 리플로우 시 솔더 내부에 기포가 갇힌 형태의 결함입니다.
영향 요인:
- Flux 용제의 휘발
- 리플로우 램프 속도
- 솔더볼 내부 산화
- UBM 표면 상태
Void는 기계적 강도를 떨어뜨리고 열 신뢰성을 저하시킵니다.
5. Bump Formation 이후 공정과의 연계
5.1 SMT/Assembly 공정
범프는 외부 기판(PWB 또는 BGA Substrate)에 실장될 단자 역할을 합니다.
범프 높이·IMC 구조·Wetting 품질은
SMT 후 리플로우 접합의 신뢰성에 직접적인 영향을 줍니다.
5.2 신뢰성 시험 영향
범프 품질이 좋지 않으면 다음 Reliability 테스트에서 조기 불량이 발생할 수 있습니다.
- TC (Temperature Cycling)
- THB (Temperature Humidity Bias)
- Drop Test
- HAST
주요 불량 모드:
- IMC Crack
- Ball Lift-off
- Stress 집중에 따른 Joint Crack
6. 마무리
Bump Formation은 WLP에서 실제 단자가 완성되는 최종 공정이며, Flux·볼 배치·리플로우·세정 품질에 의해 범프의 높이, IMC 구조, 접합 신뢰성이 결정됩니다. Fan-In WLP는 구조적 특성상 범프 편차에 민감하므로 공정 조건을 안정적으로 제어하는 것이 필수입니다. UBM 단계에서 계면 구조가 제대로 확보되면 Bump Formation 품질 역시 높은 수준으로 형성됩니다. 시드 메탈로 Cu 와 Au를 많이 사용하고 있는데 우선 기본적인 이해가 중요하니, 최소 전체적인 흐름만이라도 이해하는 것을 추천합니다.