Fan-In WLP(Wafer Level Package)는 웨이퍼 기반으로 패키징이 진행되기 때문에 RDL·PSV·UBM·Ball Drop이 모두 동일한 표면 위에서 공정이 이루어져야 합니다. 이를 위해 가장 먼저 수행되는 단계가 Base Dielectric Layer(PI/PBO 절연층) 형성입니다.
이 절연층은 RDL 패턴의 전기적·기계적 안정성을 확보하는 “Layer 0” 역할을 수행하며, Fan-In WLP 공정에서 수율 안정성의 출발점이 됩니다.
Fan-In WLP 구조를 먼저 이해해 두면 Base Layer가 어떤 역할을 하는지 훨씬 명확하게 연결됩니다.
[Fan-In WLP 구조 보기]
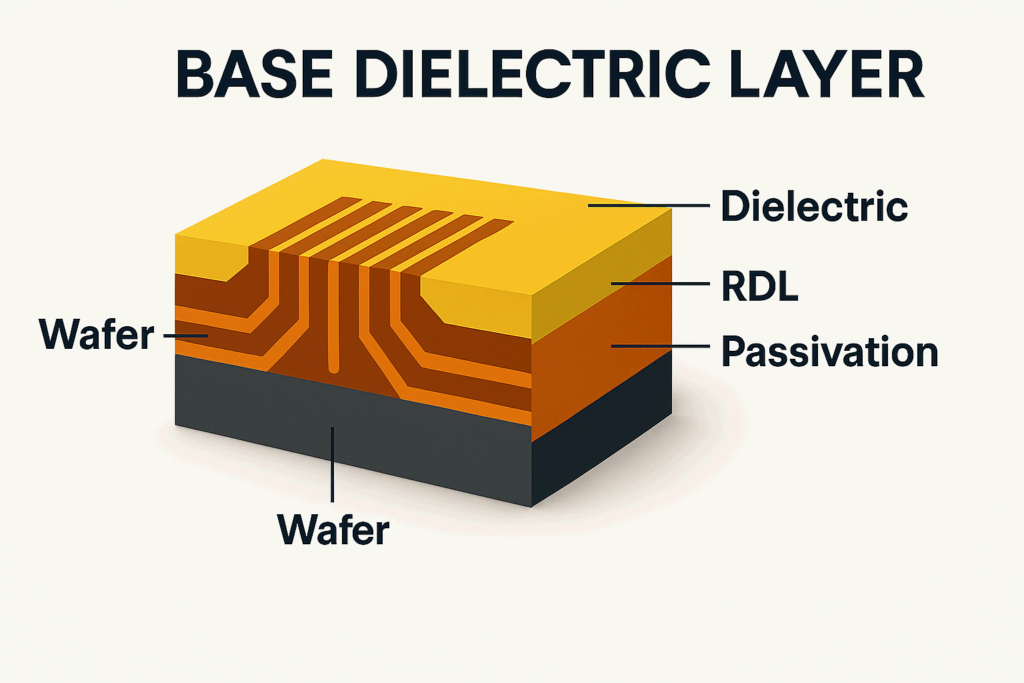
아래에서는 Base Dielectric Layer의 목적, 구조적 역할, 공정 흐름, 품질 관리 포인트를 실무 기준으로 정리했습니다.
1. Base Dielectric Layer 형성의 목적
1.1 RDL 형성을 위한 절연 기반 제공
Fan-In WLP의 RDL은 칩의 Al Pad 위에 직접 형성됩니다.
따라서 다음 조건을 만족하는 절연 기반층이 필수적입니다.
- 균일한 두께
- 우수한 전기 절연성
- Seed Layer 밀착성 확보
- 포토 공정 안정성
Base Layer가 불안정하면 RDL의 L/S(Line/Space), 도금 두께, Seed Layer 접착력까지 모두 영향을 받습니다.
1.2 Pad 보호 및 스트레스 분산
PI/PBO는 Al Pad를 외부 환경으로부터 보호하며,
후속 공정(열·도금·플라즈마 처리)에서 발생하는 기계적 스트레스를 분산하는 역할도 수행합니다.
1.3 표면 평탄화(Partial Leveling)
Fan-In에서는 FO-WLP와 달리 재편성이 없으므로 큰 단차는 존재하지 않지만
Pad 주변 ILD와 금속층 사이의 미세한 높이 차이를 완화해야 합니다.
이를 통해 RDL 포토 공정에서 초점 오류(Focus Error)를 줄일 수 있습니다.
2. Base Dielectric Layer 구조
2.1 PI/PBO 재료 구성
Fan-In WLP에서는 다음 재료들이 주로 사용됩니다.
- PI (Polyimide)
- PBO (Polybenzoxazole)
두 재질은 높은 절연성, 내열성, 수분 안정성을 갖고 있어
RDL 공정 기반 절연층으로 적합합니다.
2.2 Layer 0의 역할
Base Dielectric Layer는 회사마다 명칭이 다르지만 다음 역할은 동일합니다.
- 이후 RDL 금속을 받치는 기반층
- RDL의 Adhesion 확보
- 공정 편차를 흡수하는 버퍼 역할
- 금속과 절연막 간 계면 품질 확보
Layer 0이 안정적으로 형성되어야 RDL 두께·L/S·Seed Layer·도금 품질까지 모두 안정됩니다.
3. Base Dielectric Layer 공정 흐름
3.1 웨이퍼 표면 세정
- 유기물 제거
- 산화막 오염 제거
- Pad 표면 오염 제거
Seed Layer·도금 공정에서 밀착력에 직접적인 영향을 줍니다.
3.2 PI/PBO 코팅
Spin Coating 방식으로 도포하며 다음 조건이 핵심입니다.
- 목표 두께 균일도 확보
- Pad와 ILD 사이 단차 완화
- Edge Bead 제거
두께 편차가 크면 이후 RDL PR 패터닝 시 노광 정합에 문제가 발생합니다.
3.3 Soft Bake 및 Curing
PI/PBO는 구조적으로 Curing 과정에서 화학반응을 완성합니다.
관리 포인트:
- Bake 온도 프로파일
- 잔류 용매 제거
- 열수축 최소화
과도한 열수축은 이후 RDL 패턴 변형의 주요 원인입니다.
3.4 Via 오픈 준비
RDL이 Al Pad와 연결되기 위해 Via 오픈이 필요합니다.
Via가 정확히 오픈되지 않으면
- RDL 오픈 불량
- 접속 저항 상승
- Seed Layer 불량
이 발생합니다.
3.5 표면 검사
- 두께 균일도 측정
- 표면 거칠기 확인
- Via 오픈 정합 검사
이 단계는 RDL로 넘어갈 수 있는지 판단하는 품질 게이트 역할을 수행합니다.
4. Base Dielectric Layer 형성에서 발생하기 쉬운 문제
4.1 두께 불균일
원인: Spin 속도·점도 편차·Coating 환경
영향: PR 두께 편차, RDL 패턴 오차
4.2 Via 오픈 오버/언더 에칭
언더: Pad 접속 불량
오버: PI 손상 → 절연 문제
4.3 표면 거칠기(Ra) 증가
Seed Layer 밀착력이 떨어져 RDL 도금 불량으로 이어질 수 있습니다.
4.4 열처리 수축
Cure 과정에서 수축이 발생하면 RDL 정합도가 떨어집니다.
5. Base Dielectric Layer 이후 공정과의 연계성
Base Layer는 모든 후속 Fan-In WLP 공정의 기초가 되며 다음 공정 품질과 직접 연결됩니다.
| 공정 | Base Layer가 미치는 영향 |
|---|---|
| RDL | Seed Layer 밀착력, L/S 균일도 |
| PSV | 패턴 정합성, 절연 품질 |
| UBM | 금속 박리, 계면 신뢰성 |
| Ball Drop | 범프 높이 균일도 |
즉, Fan-In WLP에서 Base Layer 품질은 수율을 결정하는 가장 중요한 요소 중 하나입니다.
6. 마무리
Fan-In WLP 공정에서 Base Dielectric Layer는 단순 절연막이 아니라 RDL·PSV·UBM·Ball Drop까지 이어지는 전체 공정 플랫폼 역할을 합니다. PI/PBO의 두께 균일도, Via 오픈 정밀도, Cure 조건 등은 모든 공정의 품질을 결정하는 핵심 요소입니다. Fan-In WLP 구조를 이해하고 Base Layer를 공정 초기에 안정적으로 확보하면 전체 공정 수율과 신뢰성이 크게 향상됩니다.