ASSY(Assembly, 패키징) 공정의 목적, 구조, 패키지 종류, 공정 흐름을 전공정–테스트–후공정 관점에서 정리한 기술 가이드입니다.
ASSY(Assembly)는 전공정(Fab)에서 제조된 칩을 외부 환경으로부터 보호하고, 시스템 기판과 연결해 사용할 수 있도록 패키지 형태로 완성하는 공정입니다. 패키징은 단순한 기계적 보호 역할을 넘어, 전기적 성능·열 특성·신뢰성을 결정하는 핵심 요소입니다.
전공정 이후 칩 상태는 EDS(Electrical Die Sort)에서 먼저 평가됩니다. EDS 결과를 기반으로 어떤 칩이 패키징으로 투입될지 결정되기 때문에 패키징 공정의 출발점은 EDS라고 할 수 있습니다.
[EDS 공정 살펴보기]
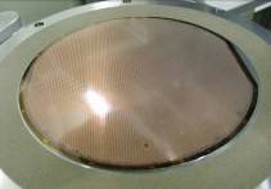
ASSY는 Wirebond, Flip-Chip, WLP, FO-WLP 등 다양한 패키징 기술을 포함하는 가장 큰 상위 개념입니다.
1. ASSY 공정의 목적
1.1 칩 보호
실리콘 다이는 매우 취약하기 때문에 외부 충격, 습기, 산화 등으로부터 보호할 구조가 필요합니다.
1.2 전기적 연결 확보
칩 내부 패드와 외부 기판(BGA, PCB 등)을 전기적으로 연결하는 기능을 수행합니다.
1.3 열 관리
칩 동작 시 발생하는 열을 효과적으로 분산시켜 신뢰성을 확보합니다.
1.4 패키지 형태 제공
패키지는 시스템 설계자가 손쉽게 사용할 수 있는 형태로 제공되며, 용도에 따라 다양한 규격이 존재합니다.
2. ASSY 공정의 큰 분류
ASSY에는 여러 방식이 존재하며, 목적·코스트·성능에 따라 채택되는 구조가 달라집니다.
2.1 와이어본드(Wirebond) 패키지
가장 오래된 패키징 방식으로, 금선/동선/알루미늄선으로 칩 패드와 리드프레임 또는 기판을 연결합니다.
대표 형태: QFN, SOP, TSOP, CSP 등
2.2 플립칩(Flip-Chip) 패키지
칩을 뒤집어 Bump를 통해 기판과 직접 연결하는 방식입니다.
고성능·고핀수 패키지에 적합합니다.
대표 형태: FC-BGA, FC-CSP
2.3 WLP(Fan-In) 패키지
웨이퍼 수준에서 패키지를 완성하며, 칩 크기와 패키지 크기가 동일한 구조입니다.
모바일, 웨어러블에 널리 사용됩니다.
WLP 세부 공정은 아래 시드에서 확인할 수 있습니다.
[WLP 공정 보기](여기에 시드 1 링크)
2.4 FO-WLP(Fan-Out WLP)
칩을 재편성한 뒤 주변에 RDL을 확장하는 패키지 방식으로, 고핀수·고집적 제품에 적합합니다.
재편성(Reconstitution) 기술이 핵심입니다.
FO-WLP는 ASSY 범주 내 “고급 패키징(Advanced Packaging)”으로 분류됩니다.
3. ASSY 공정 흐름
ASSY의 전체 구조는 다음과 같은 순서로 진행됩니다.
- Die Preparation
- Die Bonding or Reconstitution
- Interconnect 형성(Wirebond 또는 Bump 공정)
- Mold(EMC) 성형
- 패키지 외곽 가공(Singulation)
- Final Test
- Tape & Reel 또는 배송 패키징
각 패키지 방식마다 일부 단계 구성은 다르지만, 전체적인 목적은 동일합니다.
3.1 Die Preparation
- 전공정 웨이퍼의 Back Grinding
- EDS 결과 기반 Good Die 선택
- Pick & Place 준비
3.2 Interconnect 형성
패키지 종류에 따라 다음 두 가지 방식으로 나뉩니다.
3.2.1 Wirebond
칩 패드와 리드프레임(또는 기판)을 금선이나 동선으로 연결합니다.
3.2.2 Flip-Chip
칩을 뒤집어 Bump를 기판에 직접 접합합니다.
이 방식은 WLP와 FO-WLP에서도 사용됩니다.
3.3 Mold(EMC 성형)
칩을 EMC로 감싸 보호 구조를 만듭니다.
FO-WLP에서는 재편성된 웨이퍼에 적용됩니다.
3.4 Singulation
패키징된 패널을 개별 패키지 단위로 절단합니다.
3.5 Final Test
ASSY 이후에는 FT(Final Test)에서 패키지의 최종 전기적 특성을 검사합니다.
4. ASSY에서 패키지 형태가 결정되는 기준
4.1 핀수와 배선 구조
핀수가 많고 복잡한 배선이 필요하면 FO-WLP 또는 FC-BGA가 선택됩니다.
4.2 전력 및 발열 특성
발열이 큰 고성능 칩은 Flip-Chip 구조가 적합합니다.
4.3 크기 제약
초소형 기기에는 WLP가 가장 유리합니다.
4.4 비용
와이어본드는 비용이 낮고, FO-WLP·FC 구조는 비용이 높습니다.
5. ASSY와 WLP·FO-WLP의 관계
ASSY는 “패키징 전체”를 의미하는 상위 개념이며,
아래 기술들은 모두 ASSY 내부의 세부 패키지 방식입니다.
- WLP: Fan-In 구조
- FO-WLP: Fan-Out 구조
- PLP: 대면적 패널 기반 Fan-Out
- RCP/M-Series: FO-WLP 파생 기술
- FC-BGA: Flip-Chip BGA 구조
FO-WLP 공정은 ASSY 중에서도 “Advanced Packaging” 기술군에 분류됩니다.
세부 공정 흐름은 아래 페이지에서 확인할 수 있습니다.
[FO-WLP 공정 보기](여기에 FO-WLP 서브 콘텐츠 링크)
6. 마무리
ASSY는 단순한 칩 보호 단계가 아니라, 칩을 실제 제품에서 사용할 수 있는 형태로 완성하는 전기적·기계적·열적 구조 형성 과정입니다. WLP·FO-WLP·Flip-Chip·Wirebond 등 다양한 방식이 ASSY 범주 아래 존재하며, 제품 특성·비용·신뢰성 기준에 따라 패키징 방식이 결정됩니다. EDS 결과와 고객 요구 스펙을 기반으로 최적의 패키지 구조가 정해지고, 이후 공정 흐름이 구성됩니다.