WLP 공정에서 핵심 배선 구조를 만드는 RDL 공정을 실무 기준으로 정리했습니다. 배선 재배치, 도금, 노광, 절연층 형성과 관련된 주요 요소를 포함합니다.
WLP Fan-In 구조에서 RDL(Re-Distribution Layer)은 칩 내부 패드의 위치를 외부 범프 위치로 재배치하는 주요 배선층입니다. 패키지 크기와 칩 크기가 동일한 Fan-In WLP에서는 RDL 설계와 형성 품질이 전체 패키지 신호 성능과 수율을 좌우합니다. RDL은 이전 단계인 Base Dielectric Layer(PI/PBO) 위에 균일하게 형성되어야 하며, 이 절연층은 RDL의 미세 패턴 정밀도와 금속 밀착력에 직접적인 영향을 줍니다.
Base Dielectric Layer를 이해하면 RDL의 목적과 형성 방식이 더욱 명확해집니다.
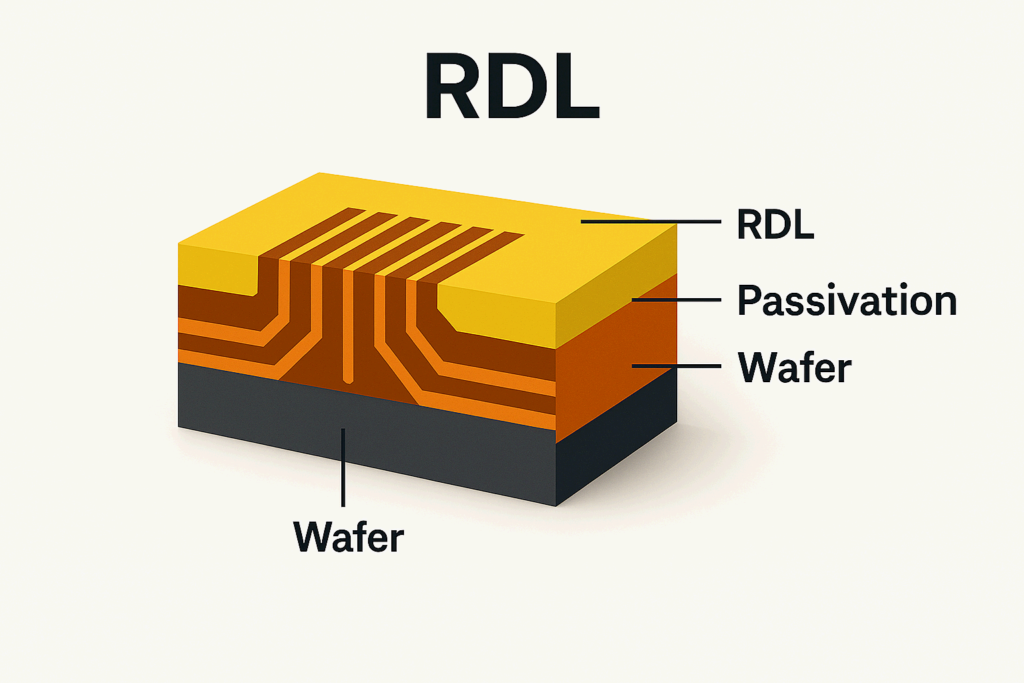
다음은 WLP Fan-In에서 실제로 사용되는 RDL 공정 흐름과 구조적 특징을 알아보도록 하겠습니다.
1. RDL 공정 개요
1.1 RDL의 역할
RDL은 칩 패드가 모여 있는 좁은 영역에서 배선을 외곽으로 확장해 솔더 범프의 위치에 맞도록 재배치하는 기능을 합니다. 이는 전기적 인터페이스의 효율성을 높이고, 제품 특성에 맞는 단자 배열이 가능하도록 합니다.
1.2 RDL이 중요한 이유
- 패드 수와 범프 수가 일치하지 않는 문제 해결
- 신호 품질 확보(저저항, 짧은 경로, 낮은 인덕턴스)
- 고핀수 제품에서 배선 밀도 확대
- 다층 구조를 통한 설계 유연성 확보
WLP의 신뢰성과 수율은 RDL의 균일성, 도금 품질, 절연 특성에 크게 좌우됩니다.
2. RDL 구조
2.1 절연층(Dielectric Layer)
RDL 형성 전후로 절연층이 존재하며 일반적으로 PI(Polyimide) 또는 PBO(Polybenzoxazole)가 사용됩니다.
절연층의 역할은 다음과 같습니다.
- 금속 배선 보호
- 누설 전류 방지
- 금속 패턴 간 절연 유지
2.2 금속층(Metal Layer)
RDL 배선은 대부분 구리(Cu)로 형성되며, Seed Layer 위에 도금을 통해 원하는 두께를 확보합니다.
배선 너비(Line)와 간격(Space)은 공정 능력에 따라 달라지며
일반적으로 5/5 µm ~ 10/10 µm 범위가 대표적입니다.
2.3 구조 반복
필요에 따라 RDL은 한 층 또는 두 층 이상으로 구성될 수 있으며, 각 층은 절연층과 금속층이 반복되는 형태입니다.
3. RDL 공정 흐름
3.1 절연층 도포 및 경화
RCF 기반층 위에 절연층을 도포하고 열처리(Cure)를 통해 경화합니다.
경화 품질이 좋지 않으면 금속 밀착력 저하 또는 배선 단차 문제가 발생할 수 있습니다.
3.2 Seed Layer 증착
Cu 도금을 위한 Seed Layer를 스퍼터링 방식으로 증착합니다.
Seed Layer 밀착력은 도금 균일성과 배선 신뢰성을 좌우합니다.
3.3 포토 공정(PR Coating → 노광 → 현상)
- PR 패턴을 통해 RDL 배선 형태를 확보
- 이 단계에서 라인 폭·간격의 공정 오차가 결정
- Warpage나 RCF 기반 불량이 있으면 초점 불량 발생 가능
3.4 Cu 도금
PR 패턴이 형성된 영역에 Cu 도금을 통해 배선 두께를 확보합니다.
일반적으로 5~20 µm 범위에서 두께를 조정하며, 두께 균일도는 배선 저항 값에 직접적인 영향을 줍니다.
3.5 PR 제거 및 Seed Layer 에칭
- 도금 후 PR을 제거
- Seed Layer를 불필요한 영역에서 에칭
- 최종 RDL 패턴이 완성
3.6 상부 절연층(Top Dielectric) 형성
RDL 보호와 UBM 공정을 위한 표면 절연 목적입니다.
Top Dielectric 품질이 낮으면 패턴 크랙, UBM 부착 불량 등으로 이어질 수 있습니다.
4. RDL 공정에서 발생하기 쉬운 문제
4.1 미세 패턴 붕괴
PR이 충분히 견고하지 않거나 도금 스트레스가 큰 경우 발생할 수 있습니다.
4.2 도금 두께 편차
웨이퍼에 미세한 휨(Warp)이 존재하면 도금 균일도에 영향을 줍니다.
4.3 Seed Layer 박리
절연층 표면 상태가 좋지 않으면 금속층이 들뜨는 문제가 발생합니다.
4.4 절연층 크랙
Cure 조건 불량 또는 열 스트레스에 의해 발생하며, UBM 단계에서 문제가 됩니다.
5. RDL 이후 공정과의 관계
5.1 PSV 공정과의 연계
RDL 패턴 위에 PSV가 형성되므로 RDL 상부 표면의 청정도와 거칠기(Ra)는 매우 중요합니다.
오염이 남아 있으면 PSV 밀착력이 떨어지고 패드 오픈 시 결함이 발생할 수 있습니다.
5.2 UBM·Ball Drop 공정과의 연계
범프가 형성되는 위치는 RDL 패턴에 의해 결정됩니다.
따라서 패드 오차, 라인 편차, 도금 불균일은 이후 범프 형성 품질에 직접적인 영향을 줍니다.
6. 마무리
WLP Fan-In에서 RDL은 단순한 재배선 기능을 넘어 패키지 전기 성능을 결정하는 핵심 구조입니다. 배선 폭, 도금 두께, 절연 품질, Seed Layer 접착력 등은 모두 수율과 신뢰성에 직결됩니다. Base Dielectric Layer가 안정적으로 형성되어 있다면 RDL은 높은 패턴 품질을 확보할 수 있으며, PSV·UBM·Ball Drop까지 이어지는 전체 공정 품질 역시 안정적으로 유지됩니다.